凸点分离后键合面的金面积比测量解决方案
1. 背景随着封装微型化和空间节省技术在现代电子设备中提高产品的整体性能,倒装芯片键合(FCB)应用越来越多,其特点是安装占地面积小,布线距离缩短。
2.应用
倒装芯片键合涉及通过金凸块将片上电JI键合至印制电路板(PCB)电JI。在不添加额外布线的情况下,键合强度直接影响电路的导电性。由于键合合金有助于增强键合强度,因此检测人员通过测量非合金的金电JI的面积比能够确定凸点和电路板间的键合度。
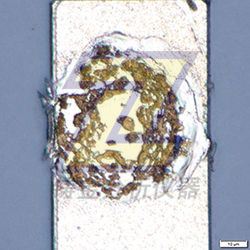
奥林巴斯的DSX1000数字式显微镜通过与高数值孔径/低像差物镜的结合,可达到与Z新光学显微镜相当的分辨率。通过景深扩展图像(EFI)技术,用户即使在难以聚焦的表面配置下也能够在整个视野中采集清晰的图像。所采集的图像直接通过OLYMPUS Stream软件传输进行测量。用户可通过HSV设置进一步细化测量区域。
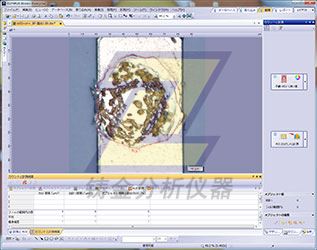
来源:奥林巴斯网站

